第三代半导体互连材料与低温烧结纳米铜材的研究进展
柯鑫, 谢炳卿, 王忠, 张敬国, 王建伟, 李占荣, 贺会军, 汪礼敏
无机材料学报
2024, 39 ( 1):
17-31.
DOI:10.15541/jim20230345
半导体材料是现代科技发展和产业革新的核心, 随着高频、高压、高温、高功率等工况的日趋严峻及“双碳”目标的需要, 以新型碳化硅(SiC)和氮化镓(GaN)等为代表的第三代半导体材料逐步进入工业应用。半导体产业的贯通以及市场规模的快速扩大, 导致摩尔定律正逐渐达到极限, 先进封装互连将成为半导体行业关注的焦点。第三代半导体封装互连材料有高温焊料、瞬态液相键合材料、导电胶、低温烧结纳米Ag/Cu等几个发展方向, 其中纳米Cu因其优异的导电导热性、低温烧结特性和良好的可加工性成为一种封装互连的新型方案, 具有低成本、高可靠性和可扩展性, 近年来从材料研究向产业链终端应用贯通的趋势非常明显。本文首先介绍了半导体材料的发展概况并总结了第三代半导体封装互连材料类别; 然后结合近期研究成果进一步围绕纳米Cu低温烧结在封装互连等电子领域中的应用进行重点阐述, 主要包括纳米铜粉的粒度、形貌、表面处理和烧结工艺对纳米铜烧结体导电性能和剪切性能的影响; 最后总结了目前纳米铜在应用转化中面临的困境和亟待解决的难点, 并展望了未来的发展方向, 以期为低温烧结纳米铜领域的研究提供参考。
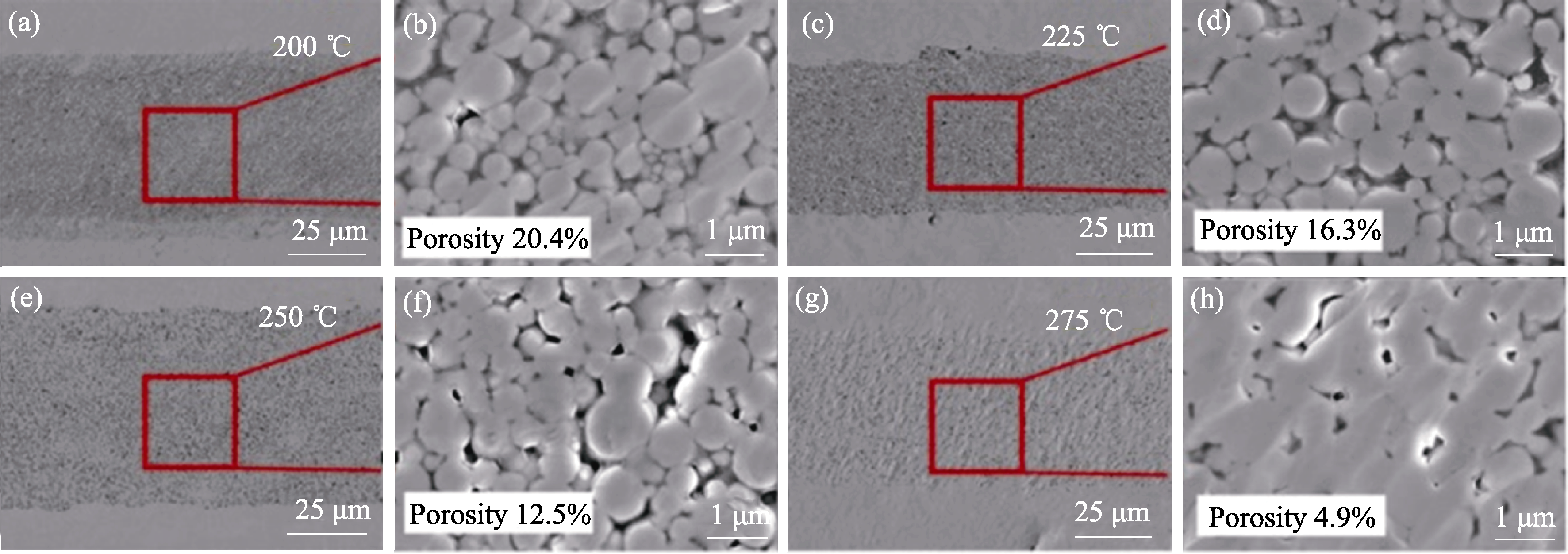
View image in article
图13
在不同温度下烧结试样的截面SEM照片[102]
正文中引用本图/表的段落
对纳米铜粉低温烧结工艺也进行了系统性研究, 主要集中于烧结气氛、烧结温度、烧结时间和有无加压方面的研究。为有效去除铜纳米颗粒表层氧化物, 通常在还原性气氛和惰性气氛下烧结, 此外, 甲酸气体[100]作为烧结气氛也引起了关注。烧结压力是通过加压使纳米铜颗粒之间充分接触, 增强结合性能, 同时也是降低烧结温度的一个有效手段, 但压力过大易造成半导体器件失效, 所以在烧结过程中, 需要控制施加在样品上的压力。Yamakawa等[101]研究了烧结过程中对接头施加的压力对接头剪切强度的影响, 并在250 ℃, 15 MPa条件下获得了剪切强度约为30 MPa的铜-铜互连接头。Li等[102]将粒径约为500 nm的铜纳米颗粒与乙二醇(EG)混合形成由30%的铜粉和70%的乙二醇(均为质量分数)组成的适合于丝网印刷的膏状物。在275 ℃, 5 MPa, N2和HCOOH混合气氛下烧结30 min, 抗剪强度达到70 MPa。在甲酸气氛下, Cu氧化层转变为5 nm厚的非晶态层, 抑制了铜原子的扩散, 烧结层的孔隙率显著降低到4.9%。Cu纳米颗粒的形貌发生了明显的变化, 证实了晶界扩散方式占主导地位, 图13为不同温度下烧结试样的截面SEM照片。
对纳米铜粉低温烧结工艺也进行了系统性研究, 主要集中于烧结气氛、烧结温度、烧结时间和有无加压方面的研究.为有效去除铜纳米颗粒表层氧化物, 通常在还原性气氛和惰性气氛下烧结, 此外, 甲酸气体[ 100]作为烧结气氛也引起了关注.烧结压力是通过加压使纳米铜颗粒之间充分接触, 增强结合性能, 同时也是降低烧结温度的一个有效手段, 但压力过大易造成半导体器件失效, 所以在烧结过程中, 需要控制施加在样品上的压力.Yamakawa等[ 101]研究了烧结过程中对接头施加的压力对接头剪切强度的影响, 并在250 ℃, 15 MPa条件下获得了剪切强度约为30 MPa的铜-铜互连接头.Li等[ 102]将粒径约为500 nm的铜纳米颗粒与乙二醇(EG)混合形成由30%的铜粉和70%的乙二醇(均为质量分数)组成的适合于丝网印刷的膏状物.在275 ℃, 5 MPa, N 2和HCOOH混合气氛下烧结30 min, 抗剪强度达到70 MPa.在甲酸气氛下, Cu氧化层转变为5 nm厚的非晶态层, 抑制了铜原子的扩散, 烧结层的孔隙率显著降低到4.9%.Cu纳米颗粒的形貌发生了明显的变化, 证实了晶界扩散方式占主导地位, 图13为不同温度下烧结试样的截面SEM照片. ...
对纳米铜粉低温烧结工艺也进行了系统性研究, 主要集中于烧结气氛、烧结温度、烧结时间和有无加压方面的研究.为有效去除铜纳米颗粒表层氧化物, 通常在还原性气氛和惰性气氛下烧结, 此外, 甲酸气体[ 100]作为烧结气氛也引起了关注.烧结压力是通过加压使纳米铜颗粒之间充分接触, 增强结合性能, 同时也是降低烧结温度的一个有效手段, 但压力过大易造成半导体器件失效, 所以在烧结过程中, 需要控制施加在样品上的压力.Yamakawa等[ 101]研究了烧结过程中对接头施加的压力对接头剪切强度的影响, 并在250 ℃, 15 MPa条件下获得了剪切强度约为30 MPa的铜-铜互连接头.Li等[ 102]将粒径约为500 nm的铜纳米颗粒与乙二醇(EG)混合形成由30%的铜粉和70%的乙二醇(均为质量分数)组成的适合于丝网印刷的膏状物.在275 ℃, 5 MPa, N 2和HCOOH混合气氛下烧结30 min, 抗剪强度达到70 MPa.在甲酸气氛下, Cu氧化层转变为5 nm厚的非晶态层, 抑制了铜原子的扩散, 烧结层的孔隙率显著降低到4.9%.Cu纳米颗粒的形貌发生了明显的变化, 证实了晶界扩散方式占主导地位, 图13为不同温度下烧结试样的截面SEM照片. ...
本文的其它图/表
|