第三代半导体互连材料与低温烧结纳米铜材的研究进展
柯鑫, 谢炳卿, 王忠, 张敬国, 王建伟, 李占荣, 贺会军, 汪礼敏
无机材料学报
2024, 39 ( 1):
17-31.
DOI:10.15541/jim20230345
半导体材料是现代科技发展和产业革新的核心, 随着高频、高压、高温、高功率等工况的日趋严峻及“双碳”目标的需要, 以新型碳化硅(SiC)和氮化镓(GaN)等为代表的第三代半导体材料逐步进入工业应用。半导体产业的贯通以及市场规模的快速扩大, 导致摩尔定律正逐渐达到极限, 先进封装互连将成为半导体行业关注的焦点。第三代半导体封装互连材料有高温焊料、瞬态液相键合材料、导电胶、低温烧结纳米Ag/Cu等几个发展方向, 其中纳米Cu因其优异的导电导热性、低温烧结特性和良好的可加工性成为一种封装互连的新型方案, 具有低成本、高可靠性和可扩展性, 近年来从材料研究向产业链终端应用贯通的趋势非常明显。本文首先介绍了半导体材料的发展概况并总结了第三代半导体封装互连材料类别; 然后结合近期研究成果进一步围绕纳米Cu低温烧结在封装互连等电子领域中的应用进行重点阐述, 主要包括纳米铜粉的粒度、形貌、表面处理和烧结工艺对纳米铜烧结体导电性能和剪切性能的影响; 最后总结了目前纳米铜在应用转化中面临的困境和亟待解决的难点, 并展望了未来的发展方向, 以期为低温烧结纳米铜领域的研究提供参考。
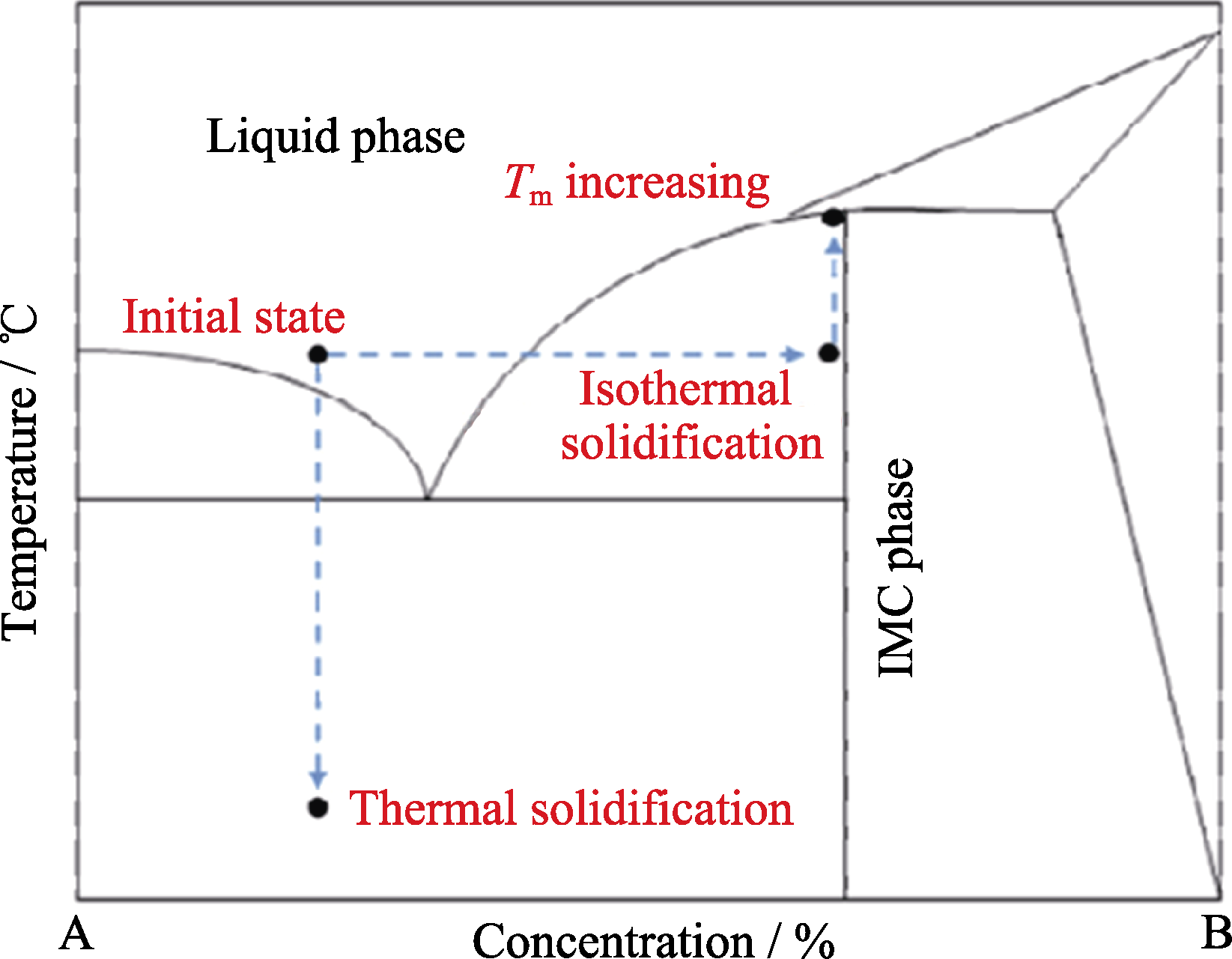
View image in article
图5
TLP键合时的虚拟平衡相图[32]
正文中引用本图/表的段落
瞬态液相(Transient Liquid Phase)键合简称TLP键合, 多用于微电子封装行业, 是焊接和扩散相结合的概念, 最初是由Leonard Bernstein于1966年提出并讨论了应用的可能性[31]。基本思想是采用低熔点的中间层熔化产生液相, 随后通过反应扩散进入基体相发生等温凝固, 形成高熔点的金属间化合物(IMC)组成的接头, 使键合层的熔点最终超过键和温度。图5为TLP键合时的虚拟平衡相图, 描述了固液界面互扩散的等温凝固过程和常规焊接时冷却的热凝固过程[32]。
Au基焊料所采用的合金体系主要有Au-Sn[ 23]、Au-Si[ 24]、Au-Ge[ 25]、Au-Sb[ 26]、Au-Ag[ 27]、Au-In[ 28]和Au-Ga[ 29]体系等, 其中Au-Sn焊料(主要是Au-20Sn共晶焊料)被视为先进封装互连的理想材料, 显示出巨大的潜力并已实现市场化.由于其合金熔点相对合适, 并且具有良好的润湿性和钎焊性能, 高的导热性和低的电阻率, 以及优异的抗氧化性, 可媲美高铅系焊料或更优[ 30].但是Au-Sn焊料含有大量的贵金属金, 价格较为昂贵, 且硬度较高, 缺乏应力松弛能力, 很难大范围使用. ... Design of lead-free candidate alloys for high-temperature soldering based on the Au-Sn system 1 2010 ... Au基焊料所采用的合金体系主要有Au-Sn[23]、Au-Si[24]、Au-Ge[25]、Au-Sb[26]、Au-Ag[27]、Au-In[28]和Au-Ga[29]体系等, 其中Au-Sn焊料(主要是Au-20Sn共晶焊料)被视为先进封装互连的理想材料, 显示出巨大的潜力并已实现市场化.由于其合金熔点相对合适, 并且具有良好的润湿性和钎焊性能, 高的导热性和低的电阻率, 以及优异的抗氧化性, 可媲美高铅系焊料或更优[30].但是Au-Sn焊料含有大量的贵金属金, 价格较为昂贵, 且硬度较高, 缺乏应力松弛能力, 很难大范围使用. ... Field-assisted bonding of glass to Si-Au eutectic solder for packaging applications. 16th IEEE Annual International Conference on Micro Electro Mechanical Systems 1 2003 ... Au基焊料所采用的合金体系主要有Au-Sn[23]、Au-Si[24]、Au-Ge[25]、Au-Sb[26]、Au-Ag[27]、Au-In[28]和Au-Ga[29]体系等, 其中Au-Sn焊料(主要是Au-20Sn共晶焊料)被视为先进封装互连的理想材料, 显示出巨大的潜力并已实现市场化.由于其合金熔点相对合适, 并且具有良好的润湿性和钎焊性能, 高的导热性和低的电阻率, 以及优异的抗氧化性, 可媲美高铅系焊料或更优[30].但是Au-Sn焊料含有大量的贵金属金, 价格较为昂贵, 且硬度较高, 缺乏应力松弛能力, 很难大范围使用. ... 1 ... Au基焊料所采用的合金体系主要有Au-Sn[23]、Au-Si[24]、Au-Ge[25]、Au-Sb[26]、Au-Ag[27]、Au-In[28]和Au-Ga[29]体系等, 其中Au-Sn焊料(主要是Au-20Sn共晶焊料)被视为先进封装互连的理想材料, 显示出巨大的潜力并已实现市场化.由于其合金熔点相对合适, 并且具有良好的润湿性和钎焊性能, 高的导热性和低的电阻率, 以及优异的抗氧化性, 可媲美高铅系焊料或更优[30].但是Au-Sn焊料含有大量的贵金属金, 价格较为昂贵, 且硬度较高, 缺乏应力松弛能力, 很难大范围使用. ... Experimental phase diagram of the AuSb-InSb section in the Au-In-Sb system 1 2014 ... Au基焊料所采用的合金体系主要有Au-Sn[23]、Au-Si[24]、Au-Ge[25]、Au-Sb[26]、Au-Ag[27]、Au-In[28]和Au-Ga[29]体系等, 其中Au-Sn焊料(主要是Au-20Sn共晶焊料)被视为先进封装互连的理想材料, 显示出巨大的潜力并已实现市场化.由于其合金熔点相对合适, 并且具有良好的润湿性和钎焊性能, 高的导热性和低的电阻率, 以及优异的抗氧化性, 可媲美高铅系焊料或更优[30].但是Au-Sn焊料含有大量的贵金属金, 价格较为昂贵, 且硬度较高, 缺乏应力松弛能力, 很难大范围使用. ... Composition design of Sn-rich Sn-Au-Ag solders using cluster-plus-glue-atom model 1 2017 ... Au基焊料所采用的合金体系主要有Au-Sn[23]、Au-Si[24]、Au-Ge[25]、Au-Sb[26]、Au-Ag[27]、Au-In[28]和Au-Ga[29]体系等, 其中Au-Sn焊料(主要是Au-20Sn共晶焊料)被视为先进封装互连的理想材料, 显示出巨大的潜力并已实现市场化.由于其合金熔点相对合适, 并且具有良好的润湿性和钎焊性能, 高的导热性和低的电阻率, 以及优异的抗氧化性, 可媲美高铅系焊料或更优[30].但是Au-Sn焊料含有大量的贵金属金, 价格较为昂贵, 且硬度较高, 缺乏应力松弛能力, 很难大范围使用. ... Development of fluxles bonding using deposited gold-indium multi-layer composite for heterogeneous silicon micro-cooler stacking. IEEE 16th Electronics Packaging Technology Conference (EPTC) 1 2014 ... Au基焊料所采用的合金体系主要有Au-Sn[23]、Au-Si[24]、Au-Ge[25]、Au-Sb[26]、Au-Ag[27]、Au-In[28]和Au-Ga[29]体系等, 其中Au-Sn焊料(主要是Au-20Sn共晶焊料)被视为先进封装互连的理想材料, 显示出巨大的潜力并已实现市场化.由于其合金熔点相对合适, 并且具有良好的润湿性和钎焊性能, 高的导热性和低的电阻率, 以及优异的抗氧化性, 可媲美高铅系焊料或更优[30].但是Au-Sn焊料含有大量的贵金属金, 价格较为昂贵, 且硬度较高, 缺乏应力松弛能力, 很难大范围使用. ... Thermodynamic characterization of solder Au-Ga alloys 1 2020 ... Au基焊料所采用的合金体系主要有Au-Sn[23]、Au-Si[24]、Au-Ge[25]、Au-Sb[26]、Au-Ag[27]、Au-In[28]和Au-Ga[29]体系等, 其中Au-Sn焊料(主要是Au-20Sn共晶焊料)被视为先进封装互连的理想材料, 显示出巨大的潜力并已实现市场化.由于其合金熔点相对合适, 并且具有良好的润湿性和钎焊性能, 高的导热性和低的电阻率, 以及优异的抗氧化性, 可媲美高铅系焊料或更优[30].但是Au-Sn焊料含有大量的贵金属金, 价格较为昂贵, 且硬度较高, 缺乏应力松弛能力, 很难大范围使用. ... Novel Au-based solder alloys: a potential answer for electrical packaging problem 1 2020 ... Au基焊料所采用的合金体系主要有Au-Sn[23]、Au-Si[24]、Au-Ge[25]、Au-Sb[26]、Au-Ag[27]、Au-In[28]和Au-Ga[29]体系等, 其中Au-Sn焊料(主要是Au-20Sn共晶焊料)被视为先进封装互连的理想材料, 显示出巨大的潜力并已实现市场化.由于其合金熔点相对合适, 并且具有良好的润湿性和钎焊性能, 高的导热性和低的电阻率, 以及优异的抗氧化性, 可媲美高铅系焊料或更优[30].但是Au-Sn焊料含有大量的贵金属金, 价格较为昂贵, 且硬度较高, 缺乏应力松弛能力, 很难大范围使用. ... Semiconductor joining by the solid-liquid-interdiffusion (SLID) proces 1 1966 ... 瞬态液相(Transient Liquid Phase)键合简称TLP键合, 多用于微电子封装行业, 是焊接和扩散相结合的概念, 最初是由Leonard Bernstein于1966年提出并讨论了应用的可能性[31].基本思想是采用低熔点的中间层熔化产生液相, 随后通过反应扩散进入基体相发生等温凝固, 形成高熔点的金属间化合物(IMC)组成的接头, 使键合层的熔点最终超过键和温度.图5为TLP键合时的虚拟平衡相图, 描述了固液界面互扩散的等温凝固过程和常规焊接时冷却的热凝固过程[32]. ... A review on recent advances in transient liquid phase (TLP) bonding for thermoelectric power module 3 2018 ... 瞬态液相(Transient Liquid Phase)键合简称TLP键合, 多用于微电子封装行业, 是焊接和扩散相结合的概念, 最初是由Leonard Bernstein于1966年提出并讨论了应用的可能性[31].基本思想是采用低熔点的中间层熔化产生液相, 随后通过反应扩散进入基体相发生等温凝固, 形成高熔点的金属间化合物(IMC)组成的接头, 使键合层的熔点最终超过键和温度.图5为TLP键合时的虚拟平衡相图, 描述了固液界面互扩散的等温凝固过程和常规焊接时冷却的热凝固过程[32]. ...
本文的其它图/表
|