第三代半导体互连材料与低温烧结纳米铜材的研究进展
柯鑫, 谢炳卿, 王忠, 张敬国, 王建伟, 李占荣, 贺会军, 汪礼敏
无机材料学报
2024, 39 ( 1):
17-31.
DOI:10.15541/jim20230345
半导体材料是现代科技发展和产业革新的核心, 随着高频、高压、高温、高功率等工况的日趋严峻及“双碳”目标的需要, 以新型碳化硅(SiC)和氮化镓(GaN)等为代表的第三代半导体材料逐步进入工业应用。半导体产业的贯通以及市场规模的快速扩大, 导致摩尔定律正逐渐达到极限, 先进封装互连将成为半导体行业关注的焦点。第三代半导体封装互连材料有高温焊料、瞬态液相键合材料、导电胶、低温烧结纳米Ag/Cu等几个发展方向, 其中纳米Cu因其优异的导电导热性、低温烧结特性和良好的可加工性成为一种封装互连的新型方案, 具有低成本、高可靠性和可扩展性, 近年来从材料研究向产业链终端应用贯通的趋势非常明显。本文首先介绍了半导体材料的发展概况并总结了第三代半导体封装互连材料类别; 然后结合近期研究成果进一步围绕纳米Cu低温烧结在封装互连等电子领域中的应用进行重点阐述, 主要包括纳米铜粉的粒度、形貌、表面处理和烧结工艺对纳米铜烧结体导电性能和剪切性能的影响; 最后总结了目前纳米铜在应用转化中面临的困境和亟待解决的难点, 并展望了未来的发展方向, 以期为低温烧结纳米铜领域的研究提供参考。
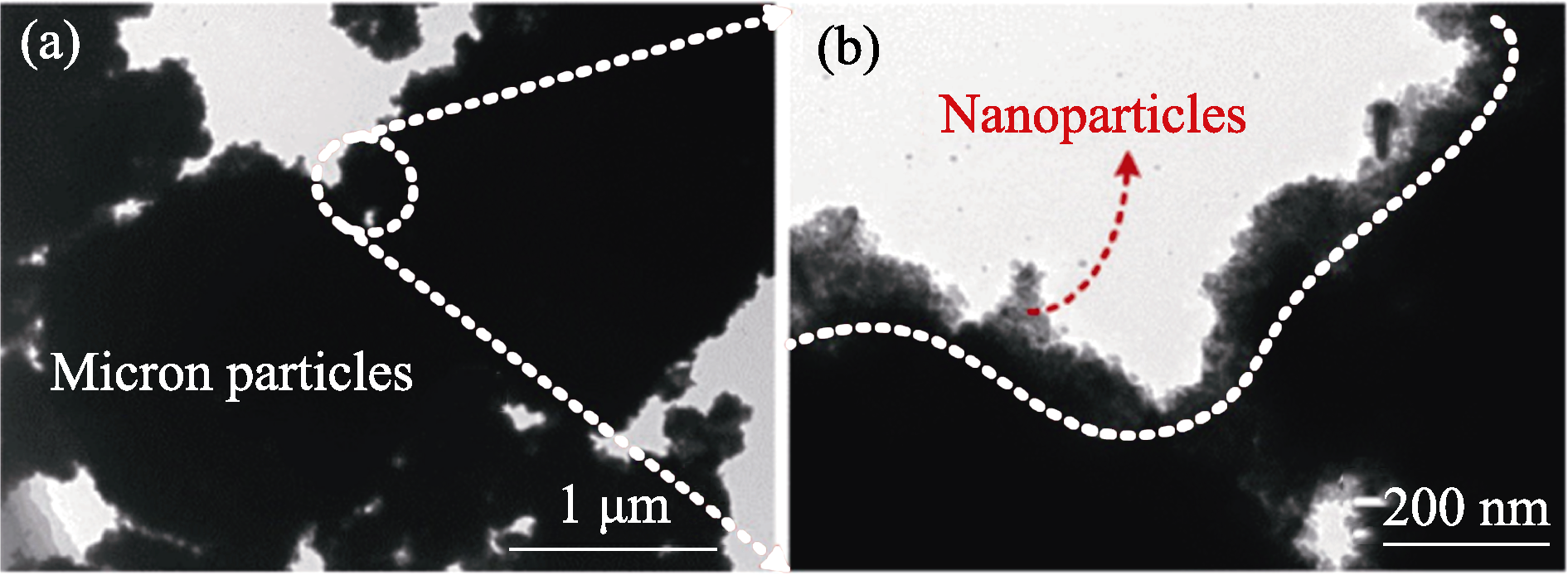
View image in article
图8
不同粒径混合的微纳米铜颗粒结构[90]
正文中引用本图/表的段落
近年来, 有文献报道, 在相同条件下, 不同粒径混合的纳米颗粒经过烧结后具有更高的结合强度, 因为大颗粒可以作为“支架”、小颗粒作为“黏结剂”, 小颗粒的填充作用可以降低连接层孔隙率, 同时小颗粒的表面扩散效应可以促进大颗粒烧结, 从而实现低温低压烧结。如图8为不同粒径混合的微纳米铜颗粒结构[90]。
(a, b) STEM images of Cu@Ag nanoparticles; (c) Schematic diagram of the filling effect of nanoparticles on silver conductive adhesive; (d) Influence of the conductive fillers’ percentages on the strength of the conductive adhesives; (e) Dependence of conductive fillers’ percentages on the strength and conductivity of conductive adhesive with 60%Cu@Ag/40% Ag plates ... Advances in low-temperature sintering of nanosilver in novel power module packages 1 2019 ... 用于半导体封装互连的低温烧结材料主要是纳米金、银、铜等为填料的膏体, 金属以超细粉末的形式在低于其常规熔点的温度下烧结致密化形成连接.纳米Ag膏一般是由纳米Ag颗粒和有机成分混合而成, 纳米Ag颗粒是最主要成分, 固含量在80%~ 90%之间.相较于块体材料和粉体材料, 纳米材料的尺寸效应导致表面原子比内部原子活性更高, 使纳米Ag颗粒具有更低的熔点和烧结温度.通过低温烧结可以实现低温连接(烧结温度可控制在150~300 ℃)、高温服役(理论服役温度可达到700 ℃以上), 此外与焊料相比具有熔点高、热导系数高、抗蠕变性能优良等特点, 可以作为SiC高功率半导体器件的封装互连材料[86].采用纳米Ag和其它纳米金属颗粒进行低温烧结的应用与研究受到广泛关注, 被认为是当前替代传统焊料,在第三代半导体封装互连应用的关键技术. ... Novel large area joining technique for improved power device performance 1 1991 ... 1989年德国西门子公司的Schwarzbauer和Kuhnert[87]发明了低温烧结Ag作为电子元器件的封装互连材料, 他们将分散在有机溶剂中的片状微米Ag以约20~30 μm厚度的层状涂覆在表面镀Ag或Au的基板上, 在约40 N/mm2的压力和210~230 ℃温度范围烧结几分钟, 使孔隙率降低到20%左右, 最终实现了芯片与基板之间的互连, 且具有较好的实用性.但受限于材料成本较高(银价格约为铜的100倍), 易发生电迁移导致失效, 使其大规模应用受到限制.理论上纳米铜可以很好地弥补纳米银的缺点并可极大降低成本, 近年来从材料研究向产业链终端应用贯通的趋势非常明显, 低温烧结纳米铜有望取代贵金属浆料和高温合金焊料. ... Effects of joining conditions on joint strength of Cu/Cu joint using Cu nanoparticle paste 1 2011 ... 烧结是一种基于原子扩散的固态传输过程, 由总表面能或界面能的减少所驱动.首先, 纳米Cu因其具有大的比表面积和高的表面能, 在烧结过程中会发生与传统微米级别粉末不同的烧结现象, 尤其是小尺寸效应所带来的烧结温度的降低, 可低至200 ℃, 远小于金属熔点的温度实现固态结合[88].其次根据Herring的尺寸法则, 当金属颗粒的尺寸从微米级减小至纳米级别时, 其烧结速率将提升12个数量级[89].因此, 纳米Cu可以在较低的烧结温度下以更快的速率烧结, 使低温烧结成为可能, 同时作为一种封装互连的替代方案, 具有低成本、高可靠性和可扩展性.科研人员致力于发展导电导热性高、力学性能优异、高温稳定性良好的纳米Cu烧结体, 已对此从纳米铜颗粒的尺寸形貌优选、表面处理和低温烧结工艺的优化等方面展开了一系列研究. ... Diffusional viscosity of a polycrystalline solid 1 1950 ... 烧结是一种基于原子扩散的固态传输过程, 由总表面能或界面能的减少所驱动.首先, 纳米Cu因其具有大的比表面积和高的表面能, 在烧结过程中会发生与传统微米级别粉末不同的烧结现象, 尤其是小尺寸效应所带来的烧结温度的降低, 可低至200 ℃, 远小于金属熔点的温度实现固态结合[88].其次根据Herring的尺寸法则, 当金属颗粒的尺寸从微米级减小至纳米级别时, 其烧结速率将提升12个数量级[89].因此, 纳米Cu可以在较低的烧结温度下以更快的速率烧结, 使低温烧结成为可能, 同时作为一种封装互连的替代方案, 具有低成本、高可靠性和可扩展性.科研人员致力于发展导电导热性高、力学性能优异、高温稳定性良好的纳米Cu烧结体, 已对此从纳米铜颗粒的尺寸形貌优选、表面处理和低温烧结工艺的优化等方面展开了一系列研究. ... Fabrication of high-strength Cu-Cu joint by low-temperature sintering micron-nano Cu composite paste 5 2020 ... 近年来, 有文献报道, 在相同条件下, 不同粒径混合的纳米颗粒经过烧结后具有更高的结合强度, 因为大颗粒可以作为“支架”、小颗粒作为“黏结剂”, 小颗粒的填充作用可以降低连接层孔隙率, 同时小颗粒的表面扩散效应可以促进大颗粒烧结, 从而实现低温低压烧结.如图8为不同粒径混合的微纳米铜颗粒结构[90]. ...
本文的其它图/表
|