第三代半导体互连材料与低温烧结纳米铜材的研究进展
柯鑫, 谢炳卿, 王忠, 张敬国, 王建伟, 李占荣, 贺会军, 汪礼敏
无机材料学报
2024, 39 ( 1):
17-31.
DOI:10.15541/jim20230345
半导体材料是现代科技发展和产业革新的核心, 随着高频、高压、高温、高功率等工况的日趋严峻及“双碳”目标的需要, 以新型碳化硅(SiC)和氮化镓(GaN)等为代表的第三代半导体材料逐步进入工业应用。半导体产业的贯通以及市场规模的快速扩大, 导致摩尔定律正逐渐达到极限, 先进封装互连将成为半导体行业关注的焦点。第三代半导体封装互连材料有高温焊料、瞬态液相键合材料、导电胶、低温烧结纳米Ag/Cu等几个发展方向, 其中纳米Cu因其优异的导电导热性、低温烧结特性和良好的可加工性成为一种封装互连的新型方案, 具有低成本、高可靠性和可扩展性, 近年来从材料研究向产业链终端应用贯通的趋势非常明显。本文首先介绍了半导体材料的发展概况并总结了第三代半导体封装互连材料类别; 然后结合近期研究成果进一步围绕纳米Cu低温烧结在封装互连等电子领域中的应用进行重点阐述, 主要包括纳米铜粉的粒度、形貌、表面处理和烧结工艺对纳米铜烧结体导电性能和剪切性能的影响; 最后总结了目前纳米铜在应用转化中面临的困境和亟待解决的难点, 并展望了未来的发展方向, 以期为低温烧结纳米铜领域的研究提供参考。
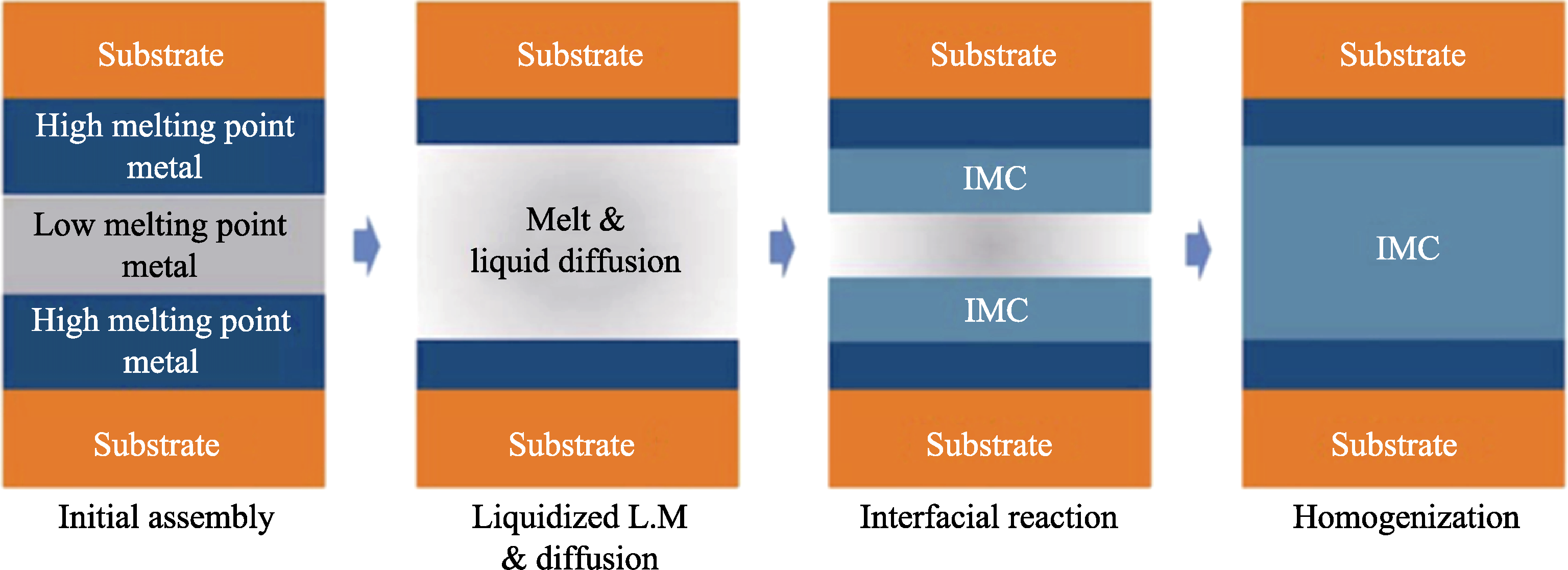
View image in article
图6
TLP键合原理示意图[33]
正文中引用本图/表的段落
传统的TLP键合原理示意图如图6所示, 结合处的低熔点和高熔点材料具有三明治结构, 此后随着温度上升, 经历了低熔点物质融化、扩散、金属间化合物(IMC)形成等阶段, 最后通过额外的热处理工艺以促进均质化, 形成均匀的金属间化合物[33]。
TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能。Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注。Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展。与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题。TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物。此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂。为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]。
传统的TLP键合原理示意图如 图6所示, 结合处的低熔点和高熔点材料具有三明治结构, 此后随着温度上升, 经历了低熔点物质融化、扩散、金属间化合物(IMC)形成等阶段, 最后通过额外的热处理工艺以促进均质化, 形成均匀的金属间化合物[ 33]. ...
传统的TLP键合原理示意图如 图6所示, 结合处的低熔点和高熔点材料具有三明治结构, 此后随着温度上升, 经历了低熔点物质融化、扩散、金属间化合物(IMC)形成等阶段, 最后通过额外的热处理工艺以促进均质化, 形成均匀的金属间化合物[ 33]. ... Trasient liquid phase bonding for power semiconductor 3 2017 ... 传统的TLP键合原理示意图如图6所示, 结合处的低熔点和高熔点材料具有三明治结构, 此后随着温度上升, 经历了低熔点物质融化、扩散、金属间化合物(IMC)形成等阶段, 最后通过额外的热处理工艺以促进均质化, 形成均匀的金属间化合物[33]. ...
TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[ 34??- 37]、Cu-Sn[ 38?????- 44]、Au-Sn[ 45???- 49]和Ag-Sn[ 50???- 54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu 6Sn 5和Cu 3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[ 55?- 57]和Ag-In[ 58- 59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[ 60]. ...
TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[ 34??- 37]、Cu-Sn[ 38?????- 44]、Au-Sn[ 45???- 49]和Ag-Sn[ 50???- 54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu 6Sn 5和Cu 3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[ 55?- 57]和Ag-In[ 58- 59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[ 60]. ... Diffusion of Cu and interfacial reactions during reflow of Sn-8.5Zn-0.5Ag-0.01Al-0.1Ga alloy on Ni/Cu substrate 1 2012 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... Nickel-tin solid-liquid inter- diffusion bonding 1 2014 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... Evolution of the intermetallic compounds in Ni/Sn-2.5Ag/Ni microbumps for three-dimensional integrated circuits 1 2015 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... Inhibition of gold embrittlement in micro-joints for three-dimensional integrated circuits 1 2014 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... Wafer-level package with simultaneous TSV connection and cavity hermetic sealing by solder bonding for MEMS device 1 2009 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... Phase transformation and grain orientation of Cu-Sn intermetallic compounds during low temperature bonding process 1 2013 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... Full intermetallic joints for chip stacking by using thermal gradient bonding 1 2016 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... Growth kinetics of Cu6Sn5 intermetallic compound in Cu-liquid Sn interfacial reaction enhanced by electric current 1 2018 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... Ultrafast formation of unidirectional and reliable Cu3Sn-based intermetallic joints assisted by electric current 1 2017 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... Non-interfacial growth of Cu3Sn in Cu/Sn/Cu joints during ultrasonic-assisted transient liquid phase soldering process 1 2017 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... A comparative study on the microstructure and mechanical properties of Cu6Sn5 and Cu3Sn joints formed by TLP soldering with/without the assistance of ultrasonic waves 1 2018 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... A diffusional model for transient liquid phase bonding 1 1997 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... Low temperature transient liquid phase bonding of Au/Sn and Cu/Sn electroplated material systems for MEMS wafer-level packaging 1 2013 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... Development of new transient liquid phase system Au-Sn-Au for microsystem technology 1 2010 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... Au-Sn SLID bonding: a reliable HT interconnect and die attach technology 1 2013 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... Microstructural characterization and mechanical performance of wafer-level SLID bonded Au-Sn and Cu-Sn seal rings for MEMS encapsulation 1 2015 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... Fluxless bonding of bismuth telluride chips to Alumina using Ag-In system for high temperature thermoelectric devices 1 2011 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... Kinetics of Ag3Sn growth in Ag-Sn-Ag system during transient liquid phase soldering process 1 2010 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... Thin layer in situ XRD of electrodeposited Ag/Sn and Ag/In for low temperature isothermal diffusion soldering 1 2008 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... Effect of process and service conditions on TLP-bonded components with (Ag,Ni-)Sn interlayer combinations 1 2015 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... Microstructure characterization and mechanical behavior for Ag3Sn joint produced by foil- based TLP bonding in air atmosphere 1 2017 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... Study of the Au/In reaction for transnsient liquid-phase bonding and 3D chip stackaging 1 2008 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... Initial interfacial reactions of Ag/In/Ag and Au/In/Au joints during transient liquid phase bonding 1 2018 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... 1 2009 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... Solid-liquid interdiffusion bonding between In-coated silver thick films 1 2002 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... Characterization of intermediate In/Ag layers of low temperature fluxless solder based wafer bonding for MEMS packaging 1 2009 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ... A review: formation of voids in solder joint during the transient liquid phase bonding process-causes and solutions 3 2019 ... TLP键合材料主要分为Sn基和In基金属, 其熔点分别为231.9和156.6 ℃, 表2为应用于TLP键合的各种材料及其性能.Sn基金属, 如Ni-Sn[34??-37]、Cu-Sn[38?????-44]、Au-Sn[45???-49]和Ag-Sn[50???-54]合金体系常被用于TLP键合材料, 其中, Ni-Sn和Cu-Sn因其成本优势而备受关注.Ni-Sn已被用作LED照明行业的高温键合材料, 但其导电性能较Cu-Sn差; 然而, 由于Cu-Sn存在氧化问题和复杂的平衡相图, 容易生成Cu6Sn5和Cu3Sn金属间化合物, 降低键合可靠性, 阻碍了其发展.与此同时, 以In为基础的Au-In[55?-57]和Ag-In[58-59]合金也被用于TLP键合材料, 但它们也存在成本和氧化问题.TLP键合接头面临的挑战是, 基本上所有的合金体系都存在大量的脆性化合物.此外, 在键合过程中形成的空隙也是裂纹生成的重要原因, 综合作用下极易导致脆性断裂.为了提高TLP键合的可靠性, 必须充分考虑脆性化合物和空隙对焊点的机械和热完整性所带来的不利影响, 进行整体的成分和结构设计[60]. ...
本文的其它图/表
|